ウエハー膜厚・バンプ高さを1台で測定可能な計測装置、リガク:独自構造ヘッドを搭載
リガクは、半導体製造工程においてウエハーの膜厚や組成、バンプ高さを1台で測定できる計測装置「ONYX 3200」の販売を開始した。チップ接点周辺に用いられる複数種の金属を同時に評価できる。
» 2026年01月06日 09時00分 公開
[EDN Japan]
リガクは2025年12月、半導体製造工程においてウエハーの膜厚や組成、バンプ高さを1台で測定できる計測装置「ONYX 3200」の販売を開始した。すでにファウンドリー顧客向けに1号機を出荷していて、2026年の売上高15億円、2027年度の同30億円を目標としている。
同製品を用いることで、半導体チップ内の金属配線形成(BEOL)およびパッケージング工程における非破壊での計測が可能。3D共焦点光学スキャナーにより、微小バンプ全体の形状と高さを立体的に取得できる。
スズ銀(SnAg)バンプは、上層のスズおよび銀の下に銅やニッケルなどが重なる構造になっている。同製品の光学計測で得たバンプ全高から、蛍光X線計測で求めた上層金属の厚みを差し引くことで、下層金属の厚さや量を間接的に算出できる。
2種のX線ヘッドを組み合わせた構造を採用
同社が独自に開発した専用ヘッドを搭載した。直径20μm以下の微細SnAgバンプに含まれる約2%程度の銀成分を、約10万分の4の精度で測定可能。2種のX線ヘッドを組み合わせた構造を採用し、チップ接点周辺に用いられる複数種の金属を同時に評価できる。
BEOLやパッケージング工程では、髪の毛より細い金属層や直径10μm以下の極小バンプを正確に評価する必要がある。一方で、従来は金属層構成に応じて複数の装置を使い分ける必要があり、工程の複雑化が課題だった。
関連記事
 6倍の高速処理を実現 リガクの全反射蛍光X線分析装置
6倍の高速処理を実現 リガクの全反射蛍光X線分析装置
リガクは、同社従来モデル比で最大6倍の高速処理を可能にした、全反射蛍光X線分析装置「XHEMIS TX-3000」を発売した。半導体製造において、ウエハー表面の微量汚染分析に対応する。 数ナノ単位の積層構造を数分で解析 所要時間は約100分の1に、リガク
数ナノ単位の積層構造を数分で解析 所要時間は約100分の1に、リガク
リガクは、半導体向けのマイクロスポット高分解能X線回折システム「XTRAIA XD-3300」の本格的な商業生産を開始した。ウエハー上の40μm角以下の微細パッド上で、数ナノメートル単位の積層構造まで非破壊で高精度に解析できる。 DUVレーザーに高出力品と波長193nm品を拡充、オキサイド
DUVレーザーに高出力品と波長193nm品を拡充、オキサイド
オキサイドは、半導体検査向けのDUVレーザー「QCW Kalama」シリーズに、波長266nmの高出力モデル(標準8W、最大12W)と波長193nmモデルを追加した。ラインアップ拡充により、検査の高感度化や新分野への応用が可能になる。 フライングプローブテスターの低価格品、タカヤ
フライングプローブテスターの低価格品、タカヤ
タカヤは、フライングプローブテスター「APT-T400J」シリーズの販売を開始した。治具不要で多品種に対応できる基板電気検査装置で、価格を抑えたスタンダードモデルだ。 サブナノメートル分解能のウエハー計測システム、Wooptix
サブナノメートル分解能のウエハー計測システム、Wooptix
Wooptixは、サブナノメートルの分解能でウエハーの形状や幾何特性を測定する計測システム「Phemet」を発表した。単一画像で1秒間に1600万超のデータポイントを取得できる。
関連リンク
Copyright © ITmedia, Inc. All Rights Reserved.
Special ContentsPR
特別協賛PR
スポンサーからのお知らせPR
Special ContentPR
Pickup ContentsPR
記事ランキング
- 「通信エラー」の原因を追う――搬送機器のコントローラーを修理【前編】
- ARM台頭にルネサス誕生……時代に翻弄され続けた日立「SuperH」
- Ankerがイヤホン用AIチップ、NORフラッシュベースCiM処理
- 「解読不可能」を破る量子コンピュータ――今から始める暗号セキュリティ
- Intelが「Core Series 3」モバイルプロセッサ、エッジ機器向けに
- フェライト(3) ―― 電子部品としてのフェライト
- アルミ電解コンデンサー(1)―― 原理と構造
- AI/HPC用ガラスビア向け 低収縮特性の銅ナノペースト
- SDVとは? 定義や課題、時代に合わせたモビリティDX戦略の重要性
- 次世代車載向けセキュリティコントローラー
Special SitePR
あなたにおすすめの記事PR
 半導体向け計測装置「ONYX 3200」 出所:リガク
半導体向け計測装置「ONYX 3200」 出所:リガク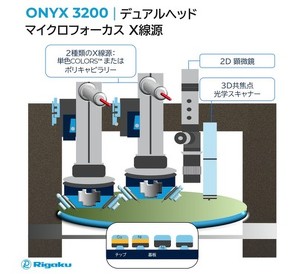 2種のX線ヘッドを組み合わせた構造のイメージ 出所:リガク
2種のX線ヘッドを組み合わせた構造のイメージ 出所:リガク


