IGBTの耐久性の定量化:パワー半導体技術(3/4 ページ)
非クランプ誘導性スイッチング(UIS)定格
この指標は、トランジェント・サージが発生したときの電力をトランジスタが安全に放散できる能力を定義します。短絡定格と同様に、この指標は異常な過渡状態を引き起こすエネルギー増大に対処するIGBTチップの能力に着目します。
図3に示すテスト回路を使用して、IGBTのUIS値を決定します。
これは、MOSFETデバイスで採用するのと同じ回路です。インダクタにエネルギーを蓄積し、IGBTのアバランシェ(電子なだれ)を引き起こし、その後、生じたエネルギーを放散する必要があります。一見すると、短絡テストを既に実施した場合は、このテストは余分な手順のように思える可能性がありますが、実際はそのようなことはありません。これら2つのテストの間には大きな違いがあります。短絡テストではデバイスはオンになり、電流密度はチップの表面全体で一様になります。それに対し、UISテストではデバイスのバイアスはオフであり、電流を通過させるためにアバランシェを引き起こす必要があります。この結果、大部分の電流はIGBTチップを一様に通過する代わりに、チップの外縁部を流れます。電流がデバイスの周辺部に密集することを考慮する必要があるので、UIS条件が発生したときに安全に対処できるエネルギーの量は、短絡が発生したときに比べて明らかに小さくなります。
チップ・レベルではIGBTのUIS定格は必ず短絡定格より小さくなりますが、パッケージに封入されたデバイス自体では必ずしもこのことが当てはまるとは限らない点に注意する必要があります。IGBTは多くの場合、逆並列ダイオードとともにパッケージに封入されます。ダイオードとIGBTそれぞれのブレークダウン電圧が正確に等しくなることは決してありません。ダイオードのブレークダウン電圧がIGBTより小さい場合は、UISテストで生じたエネルギーの大部分(または、全部)をダイオードが放散しますが、短絡テストでは常にIGBTが全エネルギーを放散します。逆並列ダイオードのチップは通常、IGBTのチップより小さく、ダイオードのUIS定格の方が低くなります。従って、類似グレードのデバイスであっても、実証的にどちらのチップが最初に動作不能になるかに応じて、UISテストの結果は大きく異なります。
図3のテスト回路では、IGBTはオンになり、コレクタ電流が事前に決定されたレベルに達するまではその状態を維持し、その後は速やかにオフになります。インダクタL1に印加される電圧は、アバランシェ状態に達する点まで上昇します。その後、エネルギーはインダクタからIGBTに伝達されます。この現象が発生した後、IGBTを確認し、引き続き正常に動作していると見なされる場合は、最終的にIGBTが故障するまでより高い電流レベルでテストを繰り返します(電流を順次増大)。障害が発生する前に到達していた最高のエネルギー・レベルが、そのIGBTのUIS定格です。IGBTを通じて放散されたエネルギーは、インダクタのエネルギーに対応します。このエネルギーは、次の式から計算できます。
EL=1/2×L×I2
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- マイコンの通信機能 UARTとI2C 、SPIの違い
- 校正やテストに使える 2線式ループ電流発生器を作ってみた
- ダイヤモンド半導体用2インチウエハー量産へ モザイク結晶開発に成功
- 「分解能0.1%」の静電容量式位置センサーを構成する
- 熱間加工磁石で材料ロス低減 EVモーター用ローター
- ON/OFFコンバーターの制御不安定問題(3)状態平均化法での結果と安定化動作に必要な位相/利得
- 次世代データセンター向け1200V SiC MOSFET、オン抵抗58%削減
- NAND/NORフラッシュメモリの違いと記録方式を分かりやすく解説
- 車両のコア機能を「一元管理」 NXPの新車載プロセッサ
- ARM台頭にルネサス誕生……時代に翻弄され続けた日立「SuperH」

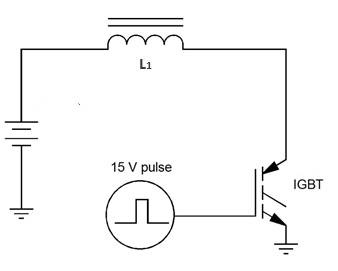 【図3】非クランプ誘導性スイッチング(UIS)測定用のUIS基本テスト回路
【図3】非クランプ誘導性スイッチング(UIS)測定用のUIS基本テスト回路


