民生向けICの「信頼性」を確保せよ:決め手は設計/製造/品質部門の密な連携(4/4 ページ)
最新プロセスと信頼性の関係
半導体業界は、ICの故障メカニズムを次々に解明し、それに対処しようとしている。しかし、微細化に伴うICの製造プロセスの変化が、信頼性の高い製品を設計するための手法を複雑にしているという側面もある。ここでは、最新のIC製造プロセス技術を適用することで顕在化した信頼性関連の項目をいくつか取り上げ、その影響について概観する。
■リーク電流
130nmノード辺りから、微細プロセスで製造したトランジスタでは、動作時のリーク電力が問題になってきた。リークにより熱が発生し、その熱がさらなるリークを引き起こすのである*4)。
リーク電力は、微細化が進むに従って、全消費電力に対してますます大きな割合を占めるようになってきている。特に、電池で駆動するモバイル機器ベンダーにとっては、リークは極めて大きな問題だ*5)。また、リーク電力の存在が、ゲーム機などの民生機器でヒートシンクや冷却ファンが必要になる理由の1つとなっている。実際、45nmプロセスへと移行すると、ICの消費電力の半分以上がリークによるものとなってしまう。
現時点では、半導体業界では信頼性面での大きな問題としてリーク電力が話題になることは少ない。消費電力を低減する新しい設計手法を模索している段階にあり、消費電力を低減することを第1の目的としてHigh-k絶縁膜/金属ゲートなどの新しい材料を採用し始めているところである。
■マルチ電圧/マルチモード
低消費電力化を主な目的とし、電源回路を最適化する手法もいくつか採用されている。その1つがマルチ電圧ドメイン/マルチモード設計であり、機能、性能、電力要件を基に回路をグルーピングするということが行われる。この手法を適用すると、信頼性試験がいくらか複雑になる可能性がある。例えば、携帯電話端末は通話時には消費電力がピークに達する動作モードとなる。電子メールの返信時には低電力モードとなり、端末を使っていないときにはスタンバイモードになる。このようなマルチモードの機器(とそれに内蔵されるIC)の信頼性試験は、各モードに対応した電源のオン/オフによるストレスなども含めたものとなり、通常とは異なる寿命試験を行わなければならない。
マルチモード設計を適用すると、ESD(electro static discharge:静電気放電)による故障も生じやすくなる。米Apache Design Solutions社のCEO(最高経営責任者)であるAndrew Yang氏は、次のように述べている。
「EMでは、時間の経過に伴って金属配線の劣化が発生する。それとは異なり、ESD故障は、急峻なサージ電流によって金属配線が溶断することによって生じる。より微細なプロセスノードでは金属配線がより細く、より薄くなるため、ESDの問題が悪化する。また、マルチ電圧ドメイン手法などの高度な低消費電力技術も、ESD故障が生じやすくなる要因となっている」。
同氏によると、ESDはICの故障原因のうち20〜30%を占めるという。対策としてESD保護回路が追加されることになるが、その効果を正確に検証するツールが必要になってきている。
■High-k絶縁膜/金属ゲート
High-k絶縁膜/金属ゲートを使用すれば、リークの問題がかなり改善される。NVIDIA社のChen氏は、「High-k材料を使用すればゲート絶縁膜を厚くすることができる。そのため、ゲートリークを抑えられる。しかし、リークはゲートだけでなく、ソース、ドレインの接合部でも生じる。トランジスタをオフにしても少量の電流が流れるわけだが、昔はチップ上のトランジスタ数が少なかったため、この電流は特に問題にはならなかった。しかし、現在ではこれが大きな問題となっている。High-k絶縁膜/金属ゲートを利用すれば、この種のリークも軽減できる」と述べている。
熱の問題に対しては、新しいトランジスタ材料に加え、パッケージやヒートシンクなどの改善にも期待が集まる。NVIDIA社のグラフィックスプロセッサでは、18カ月ごとにゲート数が2倍以上に増加しているというが、そのペースでいくと、次期製品では数十億個ものトランジスタが集積されることになる。これによって、素子の熱特性にどのような影響が生じるかは現時点では不明である。NVIDIA社は、「製品を発表する前に、ファウンドリパートナとともにかなりの研究と評価を実施し、パッケージング後やバーンイン試験中に、素子の総合的な試験を行っている」(Chen氏)という。
■プロセスばらつき
プロセスばらつきも信頼性に影響を与える要因の1つである。微細化が進むに連れ、ICメーカーは新しいプロセスに対しては高度なモデリングを、新しい製造装置に対しては高度な校正を実施しなければならなくなった。さもなければ、次の世代のプロセスへ移行するたびに、製造ラインの小さな変化によってICの性能や消費電力が目標値から大きくずれてしまうからだ。Chen氏は、「プロセスばらつきにより、素子には電気的な特性の面で差異が生じる。例えば、ゲート絶縁膜の厚さやトランジスタサイズが変化すれば、それに伴って電流特性が変化する。電流特性が変化すると、製品の寿命に変化が生じる恐れがある」と述べる。
IBM社のHergenrother氏も、ばらつきが問題の中心であることに同意する。「あるプロセスから次のプロセスへと移行するときに、同等レベルの精度を満たすようにすべての側面を制御するのはますます困難になってきている。1%の精度を満たすことが条件であるなら、30nmの配線を実現するよりも300nmの配線を実現するほうが容易だ」と同氏は述べる。
マイクロプロセッサやグラフィックスプロセッサなど、最新プロセスを利用する製品では、ばらつきの影響によって、目標とする最高性能を超えるチップが製造されてしまうことがある。その場合、そのチップは破棄しなければならない。性能が高過ぎるチップは、リークと熱が大きく、早く故障する恐れがあるからだ。これについて、Chen氏は以下のように語っている。
「チップの性能を実際に測定してみると、動作周波数が330MHz〜450MHz、リーク電流が100mA〜1A程度の範囲でばらつく。高速なトランジスタはリークも大きく、最も性能の高いチップは、リークも最大になる傾向がある。450MHz以上で動作するチップのリークは1A以上にも上るケースが多い。そのような製品を出荷することはできないので、破棄する以外に手がない」。
ファブレス企業の信頼性への対応
製造ラインを所有するか否かにかかわらず、半導体企業にとって、ICの信頼性は大きな関心事である。例えば、IBM社は自社で製品を製造しているが、それによって、製品開発のすべてのレベルにおいてトレードオフ要因を解消できるようにしている。つまり、トランジスタ開発技術や製造技術、回路レベルの設計、チップの設計、パッケージの設計、システム実装など、あらゆる分野を網羅している。こうした体制をとることで、信頼性の問題にも自社で対応できるようにしているのである。
一方、NVIDIA社やXilinx社などのファブレス企業は、製品の製造をファウンドリ企業に委託している。両社は非常に競争の厳しい市場を対象としていることもあり、ファウンドリで開発されたばかりの新しいプロセスを他社に先駆けて使用することが多い。そうした最先端のプロセスの利用に当たっては、ICの設計を開始する前に、そのプロセスがISO 9000シリーズや同14000シリーズ、OCEA(Office of the China Economic Area)などの厳しい規格を満たしていることを確認している。
Xilinx社のO'Rourke氏は、「われわれは、台湾UMC(United Microelectronics Corporation)社と東芝の両社に製造を委託している。両社が製造する当社IC製品が同等のものになるようにしなければならない」と語っている。そのために、Xilinx社はまずリファレンスモデルを開発し、UMC社と東芝がともに設計目標を達成する製品を製造できるようにしている。また、Xilinx社は、さまざまな用途で用いられる同社ICが、それぞれに求められる寿命を達成できるか否かという観点から性能解析を実施している(図A)。
O'Rourke氏は、「製品の寿命期間を模倣するために、バーンインによる加速試験を実施している。さまざまな温度と電圧で完全な特性評価を行い、製品の性能が寿命の中でどのように変化するかを調べるためだ。そのデータを利用して、製品の寿命期間における使用方法と仕様を定めている」と語る。Xilinx社は、その調査結果を顧客にも提供しているという。
脚注
※4…Santarini, Michael, "Thermal integrity: a must for low-power-IC digital design," EDN, Sept 15, 2005, p.37
※5…Santarini, Michael, "Taking a bite out of power: techniques for low-power-ASIC design," EDN, May 24, 2007, p.46
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「通信エラー」の原因を追う――搬送機器のコントローラーを修理【前編】
- 「解読不可能」を破る量子コンピュータ――今から始める暗号セキュリティ
- Ankerがイヤホン用AIチップ、NORフラッシュベースCiM処理
- Intelが「Core Series 3」モバイルプロセッサ、エッジ機器向けに
- ARM台頭にルネサス誕生……時代に翻弄され続けた日立「SuperH」
- AI/HPC用ガラスビア向け 低収縮特性の銅ナノペースト
- 次世代車載向けセキュリティコントローラー
- ADIが車載用オーディオバス「A2B」対応品を出荷 バス帯域幅は4倍
- 「耐量子暗号」対応RoTコントローラー、マイクロチップ
- アルミ電解コンデンサー(1)―― 原理と構造
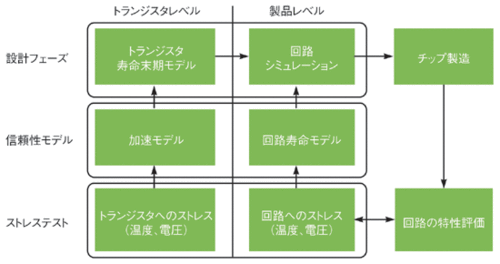 図A 信頼性への対応例 Xilinx社などの企業は、IC開発のいくつかの段階において、信頼性の検証を行っている。
図A 信頼性への対応例 Xilinx社などの企業は、IC開発のいくつかの段階において、信頼性の検証を行っている。


